 歡迎來到邁可諾技術有限公司網站!
歡迎來到邁可諾技術有限公司網站! 歡迎來到邁可諾技術有限公司網站!
歡迎來到邁可諾技術有限公司網站!
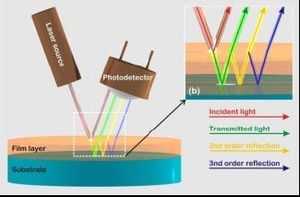
通過白光反射光譜(WLRS)和FR映射器繪制薄膜厚度
目標:在大面積上表征薄膜厚度均勻性。
測量方法:采用Fr-Basic與Fr-Mapper相結合的方法,在大面積的預定點上快速、準確地測量薄膜厚度。當樣品固定在一個Fr-Mapper上時,所有的測量都用一個Fr-Basic進行調節,使其在540-1000納米的光譜范圍內工作。反射探頭的有效光斑直徑為0.5毫米。樣品是涂有SiO2(熱的或TEOS)和Si3N4(LPCVD)/SiO2(熱的)4英寸硅晶片。在參考測量中,使用了高反射鍍鋁鏡(NT01-913-533,Edmund光學)。
結果:在圖1中,顯示了硅晶片(藍色)上的掃描區域(紅色)。有意地將6x6cm2掃描區域的中心向左下角移動。圖2a顯示了Teos SiO2的厚度值。在兩個軸上以2毫米的步幅測量薄膜厚度(總共961次測量)。計算平均厚度為635.07nm,標準差為4.24nm。小厚度為623.13nm,大厚度為641.35nm。在圖2b中,顯示了相同掃描區域熱生長SiO2(濕氧化)的膜厚值。在兩個軸上以2毫米的步幅測量厚度(總共961次測量)。平均厚度為697.29nm,標準差為0.93nm。小厚度為697.22nm,大厚度為701.32nm。熱生長SiO2的薄膜厚度變化明顯較小,而且薄膜厚度梯度呈現徑向對稱性,而Teos薄膜則并非如此。圖3顯示了Si3N4/SiO2疊層中的膜厚值。

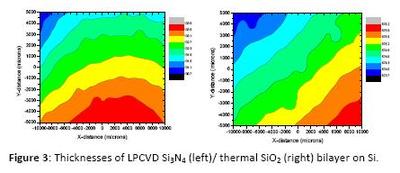
結論:Fr-Mapper與Fr-Basic連接,在單層和多層膜厚測繪中取得了成功。

Fr-Basic